生産工程

01

备料
多結晶シリコンとドーパントを一定量用意し、単結晶炉内の石英坩堝に入れます。

02

結晶が成長する
単結晶炉を利用して半導体レベルの多結晶シリコンを最高温度1500℃の熱場で溶融させた後、結晶成長によりユーザーが必要とする直径と電気的パラメータの単結晶シリコンインゴットを作製する。

03

滚圆
成長した単結晶インゴットをダイヤモンド砥石の外円研削加工を施し、研削加工後のシリコン棒を標準的な直径の円柱にする。

06

研磨
游星輪を利用してシリコンウエハを両面研磨机の上下研磨盤の間に置いて、液体研磨料を入れて、シリコンウエハを研磨盤に伴って相対的な惑星運働をさせて、そしてシリコンウエハの段に対して加圧して両面研磨加工を行って、片間と片内の厚さの公差を改善してシリコンウエハの平らさと進行度を高めます。

05

倒れた角
スライシングエッジの輪郭にダイヤモンド砥石研削加工を行い、後続シリコンウエハ加工及びデバイス工程における破片を低減する。

04

スライス
ローリング工程を経たシリコン棒を、一定の厚さのシリコンウエハーに切断する。
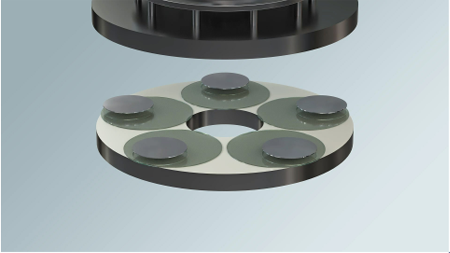
07

ひどい
研磨液によるシリコン表面の机械研磨と化学腐食の両面作用により、加工傷のないフラットな(鏡面面の滑らかな)シリコン表面を得ることができます。

08

点検
シリコンウエハ制品の標准に従って品質検査判定を実施することを要求します。

09

フォトグラフ
さまざまな規格の高品質単結晶シリコン。

10
酸化膜エッジ剥離機
酸化膜エッジ剥離機はシリコンシートエッジAPCVDプロセスで生産した酸化膜を剥離し、シリコンシートエッジ酸化膜がエピタキシャルプロセスに与える影響を除去する。

11

LPVCD
LPCVD炉はシリコンシートの裏面に固有の多結晶シリコン(i‐poly)を堆積するために用いられ,多結晶シリコン膜はシリコンシート内部の金属イオンを吸い取る役割を果たす強化型外吸雑プロセスに用いる。

10

APCVD
APCVD炉は、シリコンウエハの裏面に低温酸化膜(LTO)を堆積させ、シリコンウエハのエピタキシャルプロセス中にシリコンウエハ内部のドーパントが裏面オーバーフローによってシリコンウエハの正面のエピタキシャル層に拡散することを防止するために用いられる。
コア技術
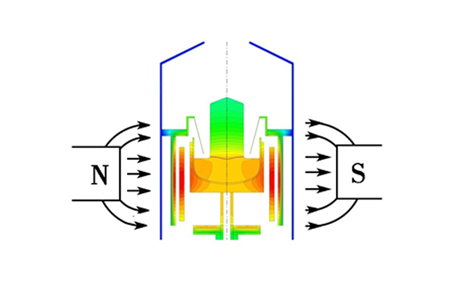
再投入ストレート技術
何回も材料を投入して、設備の効能と坩堝の利用率を高めて、ドーパントのファイル率を高めます。

磁界直線単結晶シリコン技術
低酸素、低格子欠陥密度、均一な径方向ドーピングを実現するストレート単結晶制品。
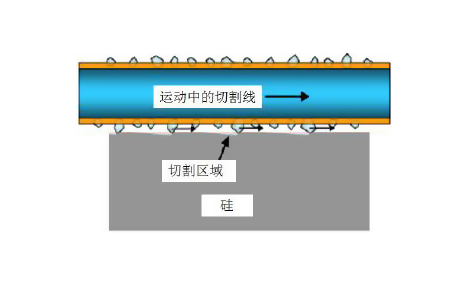
半導体単結晶金剛線多線切断
金剛線多線切断技術は、伝統的なモルタル切断に比べて、切断速度が速く、一枚の消耗品が少なく、一枚のコストが低く、スライス厚さが均一で、現在の先進的な材料加工技術です。

 中晶科技(003026)
中晶科技(003026)

